|
��(B)���s��P�͆ξ���(Cz-ֱ����)늳صĹ�˥�F������1973���Ѱl�F��ԓ��˥֮�l�F��һ���̶Ȼ֏͵ġ�Jan Scht�l�F��ԓ��˥��Ҫ�ǡ�B-O��������IJ��o����ԓȱ�ݵĽY��(2003)��Axel Herguth����ˡ������B����Փ��ጳ�ʼ��˥���ʻ֏Ͳ����ַ�����ԭ��(2006)��P�Ͷྦྷ��늳ص�˥�p�t�������������ٶ��֏��^
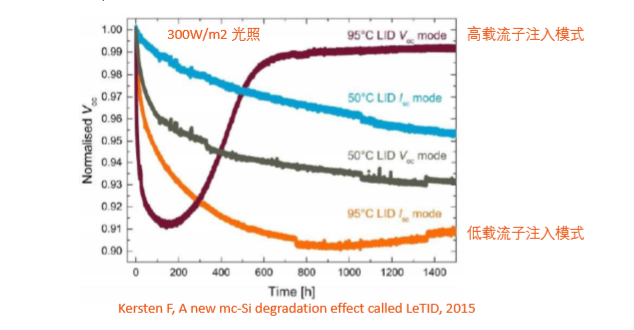 �ྦྷPERC늳��ڰ��˻�̎��(��150oC��10С�r)�r�ɰl����Ƶ�˥�p�О飬�о����J��ԓ�^���cLeTID����ͬ�ęC������˿���ͨ�^�о����˻��^���Դ_��LeTID�ĸ���ԭ����UNSW�l�FP��Cz�ξ��衢Fz�ξ����Լ�N���ڰ��˻��Ҳ���l��˥�p(���]�����˻�l������Ҋ�ڑ��⑪�ã��]�б�Ҫ��˓��Ćξ�PERC���g�Įa�I����)��UNSW�l�F��LeTID�c������P�ԣ�M. A. Jensen�J��LeTID�ǚ��c��Ƭ�е�һ�N�͎Nȱ�ݹ�ͬ���Ì��µ�(Evaluating root cause: The distinct roles of hydrogen and firing in activating light andelevated temperature-induced degradation��2018)��Kenta Nakayashiki�J�����ԭ������ǃɂ���1������ܼ�ʩ��ȱ�ݹ�ͬ�γɵ��cȱ�ݣ�2��Cu�ͺ�ȱ�ݵĘ���׃��(Engineering Solutions and Root-Cause Analysis for Light-Induced Degradation in p-Type Multicrystalline Silicon PERC Modules, 2016)��Mallory A. Jensen�t�l�F�s�|Ԫ��Cu��Ni��LeTID�^���������P�I���� (Solubility and Diffusivity: Important Metrics in the Search for the Root Cause of Light and Elevated Temperature-Induced Degradation, 2018) ��֮���ྦྷPERC��LID(��QLeTID)�ĸ���ԭ���ԛ]�ж�Փ�����]�����о��߶��Ќ����������˥�ܿ����Ƕ�N���ع�ͬ���Ì��µġ����ڮa�I���Ľ�Q�ϣ��ྦྷPERC���a����Ҫ���İ������ضྦྷ��Ƭ�|��(���ø�Ʒ�|����)���L�r�g��������̎���Լ�����늳س��S��˥�yԇ(75oC�yԇ����߳�y�l��)�����]��18���°���ྦྷ��Ƭ̎��̝���N�۵���r����Ĺ��ϡ����Ϻܿ��ܱ��õ����|�������^��Ĺ�Ƭ�ƳɵĶྦྷPERC�M����ϵ�y�д����^�ߵĝ����L�U�� Ŀǰ����늳�LeTID�Ĝyԇ�˜�����ӑՓ�У����ڶྦྷPERC�Ĺ�˥�ܿ�ֻ�г��S�yԇ�������x���H�H�����������͘Ӝyԇ�Y���ą����rֵ����һ����ྦྷ��Ƭ�����T�V��ͬλ�ã���Ƭ�Ȳ�ȱ�ݵ���r�в�ͬ����һ�����Ƭ늳�/�M���ǿ���ͨ�^����̎��������˥�ġ� 4.���Y A.P��PERC늳صĹ�˥���@���ڳ�ҎBSF늳أ������Ҫ�M�С�������̎���� B.�ξ�PERC늳صĹ�˥�ԡ�B-O����˥������ԭ���Ͽ�ͨ�^��ע�롢�ע�뼰��Ga����Q�����������̼��gˮƽ�������Ҫ��Ͷ�Y�����x��ɿ������̡� C.�ྦྷPERC늳صĹ�˥�C����s��Ҳ���l�����������^�̵��ĕr�ܾã��a�I����Ҫʹ�ø�Ʒ�|��Ƭ���ӏ�늳صij��S��˥�ܿء� |